Wie erstelle ich einen PN-Übergang eines lichtempfindlichen InSb-Chips?
In terms of mid-infrared detection in the 3-5um band, detectors based on InSb materials stand out from many material devices due to their mature material technology, high sensitivity, and good stability. InSb has become the preferred material for the preparation of mid-wave infrared detectors. Ganwafer can supply InSb wafers for infrared detectors, more specifications please view: https://www.ganwafer.com/product/insb-wafer/; oder senden Sie Ihre Anfragen ansales@ganwafer.com. Als Halbleitermaterial mit direkter Bandlücke hat InSb eine kleine effektive Elektronenmasse, eine hohe Beweglichkeit und eine schmale Bandlücke (0,17 eV bei 300 K und 0,23 eV bei 77 K). Bei niedriger Temperatur hat InSb einen hohen Absorptionskoeffizienten für Infrarotlicht (~1014cm-1), eine Quanteneffizienz größer oder gleich 80 % und eine hohe Ladungsträgermobilität (un~105cm2∙V-1∙s-1).
Mit der kontinuierlichen Entwicklung der Infrarot-Detektionstechnologie haben lichtempfindliche Chips auf der Basis von InSb-Materialien den Entwicklungsprozess von Einheitschips zu Mehrelement-, Zeilen- und Flächen-Array-Chips durchlaufen. Nach dem Flip-Chip-Verbindungsprozess werden der lichtempfindliche Chip und die Signalverarbeitungsschaltung miteinander kombiniert und auf der Brennebene des optischen Systems platziert, das die Kernkomponente der Infrarotsignalerfassung darstellt. Bei der Realisierung der photoelektrischen Umwandlung ist die Leistung des lichtempfindlichen InSb-Chips einer der Schlüsselfaktoren, die das Detektionsniveau des Brennebenendetektors bestimmen. Bei der Herstellung des lichtempfindlichen InSb-Flächenarray-Chips sind die Qualität des PN-Übergangs und die effektive Isolierung der lichtempfindlichen Pixeleinheiten die Kernschlüssel für die Herstellung des Flächenarray-Chips. Darunter ist der Herstellungsprozess des PN-Übergangs in einen Diffusionsprozess, einen Ionenimplantationsprozess und einen Epitaxieprozess unterteilt, die Haupttechnologien zur Herstellung von InSb-Infrarotdetektoren sind. Für unterschiedliche PN-Übergangs-Herstellungstechniken sind auch die entsprechenden Oberflächen-Array-Struktur-Herstellungstechniken unterschiedlich. Die Herstellungstechnologie des lichtempfindlichen Chips wird gemäß PN-Übergangsherstellungsprozessen eingeführt.
1. Thermischer Diffusionsprozess
Das Thermodiffusionsverfahren ist das erste entwickelte und ausgereifte Prozessverfahren. Das Prinzip des Prozesses besteht darin, genügend Energie für die Dotierungselementatome zu erhalten, um in den Indiumantimonidkristall einzudringen und die Gitterlücken durch das Verfahren der Hochtemperaturerwärmung zu besetzen, um die Elementdotierung und Materialmodifikation zu realisieren. Die Technologie des Diffusionsverfahrens ist ausgereift und die Ausrüstung ist einfach, aber die Steuerfähigkeit der Dotierung von Verunreinigungen ist schlecht. Daher ist die Wiederholbarkeit zwischen Chargen und zwischen InSb-Substraten in der gleichen Charge relativ schlecht, und die Gleichmäßigkeitssteuerung der großflächigen Array-Diffusion ist schlecht; während des vertikalen Einbaus von Verunreinigungselementen in das Material gibt es eine ernsthafte seitliche Diffusion, wie in Fig. 1 gezeigt. Daher ist es bei der Herstellung eines lichtempfindlichen InSb-Flächenarray-Chips gewöhnlich notwendig, eine Nassätztechnik oder eine Trockenätzung zu verwenden Technik zur Herstellung eines Mesa-Junction-Focal-Plane-Arrays (FPA).
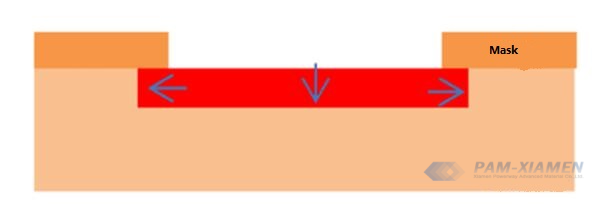
Abb. 1 Wirkungsdiagramm der lateralen Diffusion
2. Ionenimplantationsprozess
Der Ionenimplantationsprozess entstand aus dem Bedarf an PN-Übergängen mit höherer Leistung. Der Implantationsprozess ionisiert die Verunreinigungselemente durch die Ionenquellenkomponenten der Ausrüstung zu hochenergetischen Partikeln und implantiert hochenergetische Ionen mit hoher Energie von bis zu Kilogramm und Billionen in das Substratmaterial durch Rohrleitungen wie Beschleunigungsröhren, um so die Dotierung von Materialkomponenten realisieren und die Materialeigenschaften verändern. Aus dem Prozessrealisierungsprozess und dem Prozessprinzip ist ersichtlich, dass beim Dotieren des Substratmaterials im Diffusionsprozess die Dotierungskonzentration an der Oberfläche des Materials am höchsten ist. Mit zunehmender Dotierungstiefe nimmt die Dotierungskonzentration allmählich ab und der Diffusionsprozess wird zu einem abgestuften Übergang. Während des Übergangsbildungsprozesses des Implantationsprozesses werden die hochenergetischen Teilchen durch Kerne und internukleare Elektronen behindert, nachdem sie in das Substratmaterial implantiert wurden, und verlangsamen sich allmählich und bleiben in einer bestimmten Tiefe. Implantieren Sie die höchste Konzentration an einer anderen Stelle im Implantationsbereich als der Oberfläche des Substratmaterials. Die Verteilung der implantierten Elemente ist relativ konzentriert, und der gebildete PN-Übergang ist eine abrupte Übergangsstruktur. Wenn der Prozess richtig ausgelegt ist, kann ein PN-Übergang mit ausgezeichneter Leistung erhalten werden und der Rauschstrom der Vorrichtung kann reduziert werden.
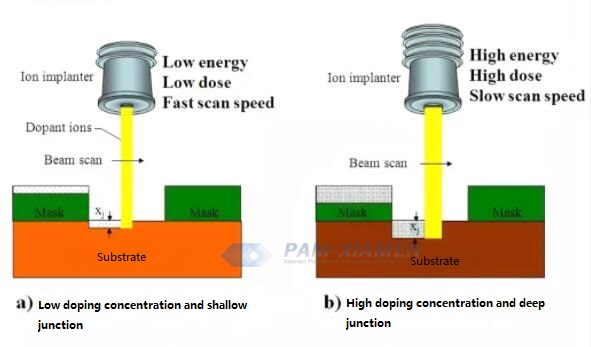
Abb. 2 Schematische Darstellung der Ionenimplantation
Für die Herstellung von infrarotlichtempfindlichen Chips auf InSb-Basis besteht der Vorteil des Ionenimplantationsprozesses darin, dass die Implantationsenergie und -dosis frei gesteuert werden können und die Menge und Tiefe der implantierten Verunreinigungen präzise gesteuert werden können, um extrem niedrig und flach zu erreichen Junction-Implantation. Die implantierten Verunreinigungen fallen gemäß dem Maskenmuster nahezu vertikal in das Basismaterial ein, und es findet keine ernsthafte seitliche Diffusion statt; Die Ausrüstung ist hochautomatisiert, wodurch eine gleichmäßige Dotierung in einem großen Bereich mit guter Wiederholbarkeit erreicht werden kann, wodurch die Genauigkeit und Wiederholbarkeit der Dotierung sichergestellt wird. Eine einzelne Verunreinigung kann genau ausgewählt werden, um die Reinheit des Dotierungselements sicherzustellen. Verglichen mit dem Diffusionsprozess erfordert der Ionenimplantationsprozess keine Hochtemperaturbehandlung und die Prozesszeit ist kürzer als der Diffusionsprozess, was die Produktionseffizienz von lichtempfindlichen InSb-Chips effektiv verbessern kann.
Im Hinblick auf die Vorteile der vertikalen Dotierungskollimation der Ionenimplantation ist die Struktur des lichtempfindlichen Flächenfeld-Chips, der an den Ionenimplantationsprozess angepasst ist, im Allgemeinen eine planare Übergangsstruktur. Der Ionenimplantationsprozess in Kombination mit der planaren Übergangsstruktur hat folgende Vorteile:
1) Reduzieren Sie Prozessschritte wie Fotolithografie, Korrosion und Ätzprozesse, die an der Pixelisolierung beteiligt sind;
2) Die Integrität des lichtempfindlichen Oberflächenarrays ist besser, Blasen treten nicht leicht im späteren Verbindungs- und Ausgabeprozess auf, und die Fähigkeit zur Reaktion auf Belastungen ist beim Prozess des Schleifens, Polierens und Verdünnens stärker;
3) Es besteht keine Notwendigkeit, eine Rillenstruktur vorzubereiten, um eine Pixelisolation zu erreichen, was den Pixelmittenabstand verringern und die Größe des InSb-Flächenarraychips verringern kann. Dadurch wird die Größe des tragenden Dewar-Gefäßes und der Kühlstruktur reduziert, und der Energieverbrauch und die Kosten werden reduziert.
3. InSb-Epitaxieprozess
Nach der Leistung zu urteilen, die die aktuellen Epitaxiefilme zeigen, ist die Epitaxie eine vielversprechende Technologie zur Herstellung von InSb-Focal-Plane-Arrays. Epitaxialwachstum ist eine Vorbereitungstechnologie zum Züchten einer neuen Einkristallschicht gemäß der ursprünglichen Kristallorientierung auf einem Einkristall-InSb-Substrat, dessen Oberfläche sorgfältig bei einer Temperatur unter dem Schmelzpunkt des Kristalls bearbeitet wurde. Ein wichtiges Merkmal der Epitaxialtechnologie besteht darin, dass während der Herstellung der epitaxialen InSb-Kristallschicht die Verunreinigungskonzentration in der Schicht eingestellt werden kann, indem der Verunreinigungsgehalt in der Reaktion gesteuert wird, der nicht durch die Art des Substrats und den Verunreinigungsdotierungsgrad beeinflusst wird . Wenn daher der PN-Übergang durch diese Technik gebildet wird, kann die Verunreinigungsverteilung nahe an der idealen abrupten Verunreinigungsverteilung liegen. Häufig verwendete Epitaxieverfahren umfassen MBE, MOCVD, LPE und MSE usw.
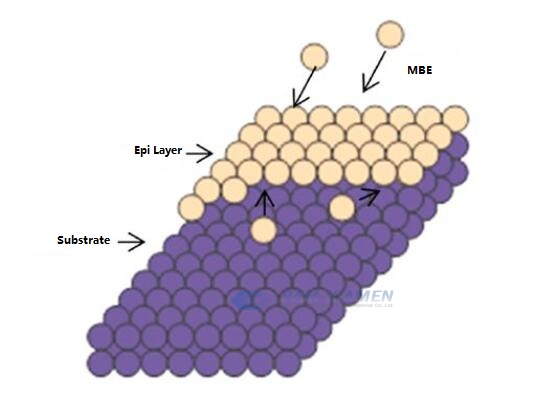
Abb. 3 Schematische Darstellung des Wachstumsprinzips der MBE-Epitaxieschicht
Der Epitaxialprozess kann fortschrittlichere Vorrichtungsstrukturen bereitstellen. Der Vorteil der Epitaxie-Technologie besteht darin, dass der Leitfähigkeitstyp des gewachsenen Halbleiters während des InSb-Epitaxie-Kristallisationsprozesses nach Bedarf gesteuert werden kann und die Dotierungsmenge von Verunreinigungen jederzeit angepasst werden kann. Es hat ein gleichmäßiges Wachstum, eine In-situ-Dotierung, eine Echtzeitsteuerung und muss nicht reduziert werden. Aufgrund der Vorteile der Dünnheit und anderer Vorteile können verschiedene Gerätestrukturen entworfen und hergestellt werden, indem die Geräteparameter im Epitaxieprozess gesteuert werden um die Herstellung von Hochtemperatur-Arbeitsgeräten und dual-polychromatischen Band-Arbeitsgeräten zu realisieren.
Da das Epitaxialverfahren das Ganzchip-Wachstumsverfahren anwendet, kann es nur zur Herstellung von Bauelementen mit Mesa-Übergangsstruktur verwendet werden.
Für weitere Informationen kontaktieren Sie uns bitte per E-Mail unter sales@ganwafer.com und tech@ganwafer.com.