InAs / GaSbタイプII超格子(T2SL)構造
Ganwafer can offer GaSbエピタキシャルウェーハタイプII超格子(T2SL)構造。 T2SLはIII-Vグループ6.1ÅSbベースの材料で、InAs(6.0583Å)、GaSb(6.09593Å)、AlSb(6.1355Å)で構成されています。層の厚さ、組成および順序。 それらの間の小さな格子不整合のために、複雑な二元または三元化合物を成長させることができます。 Sbベースの材料および関連化合物のエネルギーギャップは、0.41eV(InAs)から1.70eV(AlSb)の範囲です。 GaSbベースのタイプ2ひずみ層超格子構造の詳細については、以下を参照してください。
1. InAs /GaSbT2SL構造
GANW200622-T2SL
| T2SL構造の成長 | ||||
| レイヤーの詳細 | レイヤー素材 | 厚さ/単層数(ML) | ドーピングの種類/ドーピング濃度 | 期間数 |
| 第1層:バッファー層 | GaSb | 800nm | p+タイプ/Be:1 x1018 CM-3 | 単層 |
| 第2層:厚さ0.5µmのn +タイプ、Mバリア領域 | InAsの | – | アンドープ | 〜111期間 |
| GaSb | – | – | ||
| 第3層:厚さ2.2µmのわずかにp型ドープ(Beドーピング温度:760°C)、π領域 | InAsの | – | – | 〜330期間 |
| GaSb | – | – | ||
| InSbの | – | – | ||
| 第4層:厚さ0.5µmのわずかにドープされたn型ドープのM領域 | InAsの | – | – | 〜54期間 |
| GaSb | – | – | ||
| AlSb | – | – | ||
| GaSb | 5ML | – | ||
| 第5層:厚さ0.5µmのn +タイプ、Mバリア領域 | InAsの | – | – | 〜54期間 |
| GaSb | – | アンドープ | ||
| AlSb | – | – | ||
| GaSb | – | – | ||
| 6層目:キャップ&トップコンタクト層 | InAsの | – | n+タイプ/– | 単層 |
基板:3インチGaSb(001)基板(n型ドープ/ Te:E16)
2. InAs/GaSbタイプII超格子について
タイプIIのバンド構造を持つInAs/GaSb T2SL材料は、異なる配置期間に従ってInAs薄膜とGaSb薄膜を積み重ねることによって形成されます。 InAs層とGaSb層の間の界面では、InAs層の伝導帯の上部がGaSb層の価電子帯の下部よりも約150 meV低く、II型ヘテロ接合構造を形成しています。 T2SL材料の禁止バンド幅は、電子マイクロストリップ(C1)の下部とブリルアンゾーンの最初のヘビーホールマイクロストリップ(HH1)の上部との間のバンドギャップによって形成されます。 下の図に示すように、理論的には、フィルムの厚さと配置に応じて、タイプ2超格子の禁止バンド幅を0〜400meVの間で連続的に調整できます。
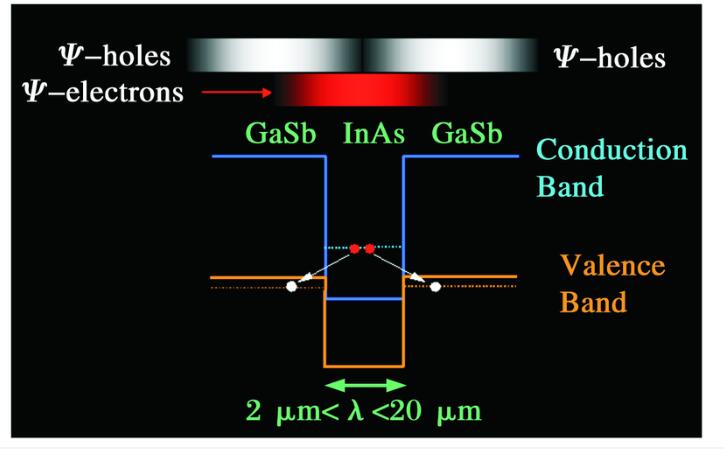
InAs/GaSb超格子のエネルギーバンド構造
3.タイプII超格子技術の応用
Sbベースの応力層超格子(SLS)、特にタイプII超格子(T2SL)材料は、検出器、レーザー、および変調器、特に赤外線検出の分野で幅広い用途があります。 大きな可能性と利点があるため、T2SL材料は、現在の主流のHgCdTe(MCT)材料に取って代わることができると一般に考えられています。 高品質のInAs/GaSbタイプII超格子材料は、分子線エピタキシー(MBE)技術によって成長し、赤外線帯域全体をカバーする高性能タイプII超格子赤外線検出器の開発に成功しました。
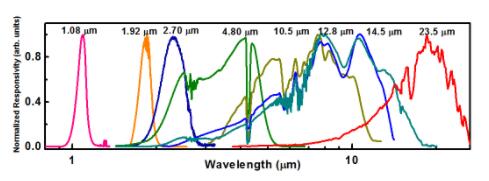
全帯域の赤外線周波数をカバーするT2SL赤外線検出器
4. InAs /GaSbT2SLの利点
GaSbの価電子帯は、InAs材料の伝導帯よりも高くなっています。 その結果、実空間で分離されたInAs層とGaSb層は、それぞれ伝導帯ポテンシャル井戸と価電子帯ポテンシャル井戸を形成します。 電子と正孔は、それぞれInAs層とGaSb層に閉じ込められています。 一方、電子の有効質量は軽く、電子の波動関数はバリア層の重なりを通過してマイクロストリップ構造を形成します。 外部赤外線の作用によって引き起こされるキャリアの遷移は、バンド間遷移に属します。 この特殊なバンド構造により、タイプII半導体超格子材料には次の利点があります。
1)バンド間遷移は、垂直入射を吸収し、高い量子効率を持つことができます。
2)ひずみとそのエネルギーバンド構造を調整することにより、重い正孔と軽い正孔の分離が大きくなり、オージェ再結合と関連する暗電流が減少し、タイプII超格子焦点面アレイの動作温度が上昇します。
3)電子の有効質量は大きく、HgCdTeの3倍です(T2SLの場合、電子の質量はmです。e約0.03m0; HgCdTeの場合、電子質量はmです。e約0.01m0)。 トンネリング電流が小さく、特に超長波で高い検出率が得られます。
4)調整可能なバンドギャップ、短波から30 umまでの調整可能な応答波長、短波、中波、長波、超長波、2色および多色デバイスを準備できます。
5)III-V材料成長技術に基づいており、大面積の材料均一性が良好で、コストが低くなっています。 タイプ2の歪み層超格子成長にMBEを使用すると、設計の自由度が高く、ドーピング制御が容易で、合金の変動やクラスターの欠陥がなく、焦点面検出器の均一性が良好です。
詳細については、メールでお問い合わせください。 sales@ganwafer.com と tech@ganwafer.com.